先进的 2.5D / 3D-IC 系统由多块裸晶、中介层、封装层和连接基板组成,这使得耦合效应更加具有挑战性。多晶体异质整合(HI)的出现,将不同的制程技术和电气特性整合在一起,需要依靠超越现有的设计工具和流程与更强设计和验证能力。从系统封装(SIP)到带有中介层的先进封装的 2.5D-IC 以及真正的 3D 电路,既有讯号网络又有电源供应网络的新兴连接架构急需具有超大的数据容量、高度可扩展计算能力与具创新技术的电子设计自动化(EDA) 解决方案。
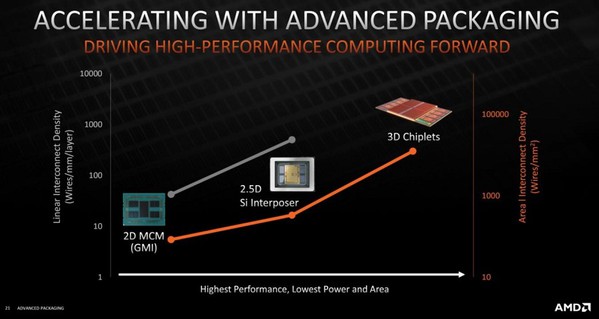
| 图一 : 2.5D 和 3D-IC 可实现持续扩展、更高性能和更低功耗。 |
|
ACCELERATING WITH ADVANCED PACKAGING
多物理的挑战
...
...
| 另一名雇主 |
限られたニュース |
文章閱讀限制 |
出版品優惠 |
| 一般使用者 |
10/ごとに 30 日間 |
0/ごとに 30 日間 |
付费下载 |
| VIP会员 |
无限制 |
25/ごとに 30 日間 |
付费下载 |

